차세대 메모리 장치를 위한 강유전성 HfO2의 잠재력: 강유전성 특성 및 응용
The Potential of ferroelectric HfO2 for Next-Generation Memory Device: Ferroelectric Properties and Applications
Article information
Trans Abstract
The discovery of the ferroelectricity of HfO2 in 2011 has opened up new avenues for the application of ferroelectric technology. With the stability of ferroelectricity in a few nm scales, HfO2 has become a valuable material for the development of next-generation electronic memory devices. The unique structure of HfO2 gives rise to various ferroelectric properties and behaviors that can be utilized in different types of devices such as ferroelectric field effect transistors (FeFETs), negative capacitance field effect transistors (NCFETs), ferroelectric tunnel junctions (FTJs), and ferroelectric capacitors (FeCAPs). In this review, we explore the potential of HfO2 for the high-density storage of data and low-energy consumption in next-generation devices. We demonstrate the operating principles and strengths of HfO2 in various device applications, shedding light on how this material can help address the electronics industry's current challenges.
1. 서론
2011년도에 발표된 산화 하프늄(Hafnium oxide, HfO2)의 강유전성에 대한 보고는 강유전체(ferroelectric materials)를 응용한 기술과 물질에 대한 이해의 폭을 크게 넓히는 계기가 되었다.[1,2] HfO2는 본래 Complementary Metal Oxide Semiconductor (CMOS) 공정에 고유전율(High-k) 물질로 응용되고 있었다.[3] 형석(Fluorite) 구조를 가지고 있는 HfO2는 일반적으로 무극성 결정상(non-polar phase)이 안정된 결정상으로 보고되었기 때문에 강유전성을 기대하기 어려웠다.[4–6] 하지만 HfO2는 페로브스카이트(perovskite) 구조의 기존 강유전성 물질들과 비슷한 수준의 잔류 분극(remnant polarization, P r) 값을 가진 것에 더해 산업기술에 응용하기에 적합한 여러 특성들이 보고되고 있다. 차세대 소자 개발을 위한 물질에 대한 기대감은 큰 관심을 끌었고, 그 결과 강유전성 HfO2를 이해하기 위한 많은 연구들이 진행되어왔다.
HfO2의 강유전성의 기원은 무엇이며 어떻게 안정화될 수 있는지, 또한 강유전성 도메인(ferroelectric domain)과 강유전 쌍극자(ferroelectric dipole)의 전환 메커니즘(switching mechanism) 등에 대한 수많은 질문들은 근본적인 이해를 풍부하게 만들었다. HfO2의 불안정한 강유전상의 안정화에 대한 연구들과 박막 성장 메커니즘에 대한 연구들은 현재 산업공정에 적합한 고품질 박막을 얻어 낼 수 있는 다양한 증착 방법들을 제시하였다.[7,8] 강유전성 도메인의 형성과 안정성에 대한 연구와 강유전성 거동에 대한 연구들은 향상된 소자성능을 구현했고, 더 나아가 뉴로모픽(neuromorphic) 소자, 음의 전기용량 전계효과 트랜지스터(negative capacitance field effect transistor, NCFET) 등과 같은 새로운 소자에 응용가능성을 넓혔다.[9,10] 소자 성능의 향상과 다양한 소자의 개발은 소자에 응용된 특성과 원리에 대한 근본적인 이해를 기반으로 이루어진다. 따라서 기술의 응용과 이해 둘 사이의 관계를 중점으로, 본 글에서는 강유전성 HfO2의 물질적 특성이 여러 형태의 소자들에 어떻게 응용되고 있는지 알아보고, 응용된 특성에 대한 연구들을 살펴봄으로써 강유전성 HfO2에 대한 근본적인 이해와 응용 기술의 발전을 돕고자 한다.
2. 본론
2.1 강유전체 HfO2
강유전체는 외부 전기장 없이 안정된 분극 상태를 유지할 수 있고, 추가적인 전기장을 가했을 때 분극 상태의 변화를 일으킬 수 있다. 잔류 분극의 안정성은 강유전체의 결정구조에 기인하는데, 비-중심 대칭(non-centrosymmetric) 결정 구조에서 원자들의 배열에 따라 전기적 쌍극자(electric dipole)들이 잔류 분극을 형성한다. 이러한 배열은 외부 전기장에 의해 위치가 변화하면서 분극 방향이 변화한다. 분극 방향의 변화를 위해서는 일정 수준이상의 전기장을 가해야 하는데 이를 항전계(Coercive field, E c)라고 부른다. HfO2의 경우 예상치 못한 강유전성을 보였고, 기존 페로브스카이트 구조의 강유전성 물질들과 전혀 다른 구조를 가지고 있기 때문에 추가적인 이해가 필요하다.
강유전성 HfO2는 2011년 Boscke et al. 에 의해 처음 보고되었다.[1] 2015년 Sang이 HfO2의 강유전성을 가지는 결정상에 대해 공간군 Pca21로 결정학적 기원을 사방정계상(orthorhombic phase)으로 결정할 때까지 강유전체상의 구조적 기원은 모호했다.[11] 특히 Pb(Zr x Ti1-x) O3(PZT), BaTiO3(BTO)과 같은 일반적인 페로브스카이트 구조 기반 강유전체와는 달리, 강유전성 HfO2는 형석 구조를 가지고 있다. 페로브스카이트 단위 격자는 격자 중심에 양이온이 존재해 양이온의 위치에 따라 서로 다른 분극을 띄는 반면, HfO2의 강유전성 Pca21상은 단위 격자 내에 4개의 산소 음이온을 갖고, 이들 산소 음이온 중 절반만이 외부전기장에 반응하여 분극 상태를 만든다.
HfO2의 강유전체상은 열역학적으로 준안정상태를 가지고 있다. HfO2의 온도와 압력에 따른 결정상에 대한 연구는 공간군 P21/c의 단사정계상(monoclinic phase)이 상온 및 대기압에서 안정적인 상태를 형성한다는 것을 보여주었다.[4] 상압에서 온도가 올라감에 따라 안정상은 1,973 K에서 정방정계상(tetragonal phase)(공간군: P42/nmc)으로 변화한 다음, 2,773 K에서 입방정계상(cubic phase)(공간군: Fm3m)으로 변화한다. 반면 상온에서 압력을 변화시키면 사방정계상이 안정화된다. 압력이 증가함에 따라, 안정적인 결정학적 상은 단사정계상에서 반극성 사방정계상(oI 공간군: Pbca)으로 변화하고, 이후 무극성 사방정계상(oII 공간군: Pnma)으로 변환된다. 강유전 결정상인 사방정계상(oIII 공간군: Pca21)은 온도와 압력 변화 사이의 적절한 조작을 통해 안정화가 가능하다.[12]
HfO2의 강유전체 결정상 안정화는 동역학적 방법으로 이루어질 수 있다. 덮개층(capping layer)의 영향이 일반적으로 주요하게 사용되는 방법 중 하나이다. 덮개층은 결정화시 온도변화 과정에서 기계적 응력을 이용하여 강유전성 사방정계상을 유도한다.[13,14] 고온에서 안정화되는 정방정계상은 상온에서 단사정계상으로 변화하지만 이때 충분한 기계적 응력이 작용하여 결정상 변화를 위한 에너지 장벽이 증가하여 결과적으로 강유전성 사방정계상이 결정화될 수 있다.
불순물 첨가를 이용한 강유전상의 안정화는 가장 널리 알려진 조작방법 중 하나이다. HfO2의 강유전성을 유도할 수 있는 불순물로는 대표적으로 Zr[15], Si[1], Al[16], Y[17], Gd[18], Sr[19] 등이 있다. 실험적으로 불순물의 크기가 작을수록 정방정계상을 유도하고, 클수록 입방정계상을 유도하는 것으로 알려져 있다.[20] 불순물의 종류에 따라서 강유전성이 발현되는 농도와 발현된 특성들이 다르다.[21] 특히, Zr의 경우, 불순물 농도의 비율에 따라 상유전체, 강유전체, 반강유전체 특성을 고루 보이며 강유전체 특성을 보이는 농도의 범위가 타 불순물들에 비해 매우 넓다. 보통 1:1 비율에서 가장 큰 강유전 특성을 나타내고, Zr의 비율이 적어질수록 상유전체, 많아질수록 반강유전성 특성을 보인다.[15]
HfO2 박막 내의 산소 공공(oxygen vacancy)의 분포는 증착 조건이나 외부 전기장 인가에 의해서 변화하고 이는 강유전성 발현에 크게 영향을 미친다. HfO2 박막 증착 시 산소 공급을 제어하거나 산소를 포함한 계면층 또는 전극을 이용하여 HfO2 박막 내의 산소 농도를 제어할 수 있다.[22] 일반적으로 페로브스카이트 박막의 산소 공공은 강유전체 도메인을 고정시키고 누설 전류를 증가시킴으로써 강유전특성을 저하시킨다.[23] 그러나, 강유전성 HfO2 박막에서, 적정량의 산소 공공은 강유전체를 유도하는데 유리하다.[24,25]
2.2 강유전체 HfO2를 이용한 FET 소자
2.2.1 강유전 전계 효과 트랜지스터 (Ferroelectric field effect transistor, FeFET)
FeFET는 1957년도 Bell Lab에서 처음 고안되었다.[26–29] 강유전체층이 트랜지스터 구조에서 게이트 영역에 포함되어 한 개의 트랜지스터(1T) 구조만으로 메모리 소자의 역할을 할 수 있다 (Fig. 1). 소자 안에 특정 정보를 입력하고 반영구적으로 보존할 수 있다는 점에서 FeFET는 큰 장점을 가지고 있었고, 이런 소자 특성을 발전시키고 산업화하기 위한 연구가 활발히 이루어져왔다.[30,31] FeFET 동작 원리는 강유전체층의 강유전 쌍극자들에 의한 전기장이 트랜지스터 채널에 끼치는 영향으로 설명할 수 있다. 강유전체 층에서 발생한 전기장은 분극 방향에 따라 강유전체층과 맞닿아 있는 계면 층에 전하를 만들고, 이로 인해 채널의 전기 전도도(conductivity)가 바뀐다. 그 예시로 n형 FeFET 를 보면, 강유전체층이 아랫방향의 분극을 가지고 있을 때, 쿨롱 법칙에 의해 채널에는 전자들이 끌려온다. 그럼 채널의 전기 전도도는 증가하고, 이로 인해 문턱전압이 낮아져 낮은 문턱 전압 상태(low threshold voltage state)가 된다 (Fig. 1. c). 반대로 윗 방향 분극을 가질 경우, 전자들은 척력을 받게 되고, 채널의 전기 전도도는 낮아져 결과적으로 높은 문턱 전압 상태(high threshold voltage state)가 된다. 이때 분극 방향에 따른 문턱 전압 간의 차이(ΔV T)를 메모리 윈도우(MW)라 한다. 분극 방향에 따른 V T와 MW를 이상적으로 나타내면, 다음과 같다.[32]

a. 소스(S), 드레인(D), 게이트(G)로 구성된 FeFET 소자 구조 모식도. 게이트층은 부분적인 도메인들을 가진 강유전층(ferroelectric layer, FE)과 하지층(Buffer layer, BL)로 구성되어 있다. b. 투과전자현미경으로 확인한 강유전성 Si:HfO2를 이용한 수십 nm 크기 수준의 FeFET 소자의 단면. c. 강유전체 분극 방향에 따른 비휘발성 메모리 소자 구조 모식도 및 분극 방향에 따른 드레인 전류-게이트 전압 (I D-V G)곡선. Reprinted with permission from Mulaosmanovic et al., ACS Applied Materials & Interfaces 2017 9 (4), 3792-3798 Copyright 2023 American Chemical Society[41].
식 1에서 V FB, ϕ B, q, N a, k s, ε0, C FE는 각각 평탄대 전압(flat-band voltage), 금속 접합에 의한 반도체층의 페르미 준위의 변화, 단위 전하, 반도체층의 도핑 농도, 반도체층의 유전상수, 진공의 유전율, 강유전체층의 전기용량(capacitance)을 나타내고, min(x, y)와 max(x, y)는 각각 x와 y값중 더 작은 값과 큰 값을 나타낸다. 위 식에서 알 수 있듯이 메모리 소자의 정보상태와 MW는 P r 값과 항전계 값에 따라 변화한다. 메모리 소자 정보상태를 정밀하게 조정하고 재현하는 것이 소자의 신뢰도를 향상시키는 것이라 할 수 있다. 때문에 소자 보존성(retention), 내구성(endurance)과 함께 강유전 쌍극자 전환 메커니즘에 대한 연구가 소자 성능 향상에 주요한 역할을 한다.[33,34]
한 개의 트랜지스터와 한 개의 축전기로 이루어진 1T-1C FeRAM소자와 달리 FeFET 강유전메모리 소자는 Si 채널과 강유전체층이 직접 접촉하기 때문에 Si 호환성이 중요한 해결과제로 떠올랐다. PZT, (Sr x Bi1-x) TiO3(SBT), (Bi x La1-x)TiO3(BLT)와 같은 기존의 강유전성 물질들은 Si과 직접 맞닿아 있을 때, 규산염과 같은 물질들이 형성된다. 이는 추가 계면층을 강제하고, 고온 후처리 과정을 불가하게 만든다. 반면 HfO2의 경우 Si 과 맞닿아 있을 경우에도 열역학적으로 충분히 안정화 되어있어 Si 채널을 이용한 FeFET 소자에 적합하다.[35–37]
탈분극 전기장(Depolarization field)은 소자의 강유 전 특성을 열화 시켜 정보 상태를 유지할 수 없게 한다. FET 구조에서 강유전층은 채널의 결핍 영역(depletion region)과 직렬로 연결되어 있고 매우 얇은 필름은 일반적으로 탈분극 전기장에 의한 효과를 겪는데, 이는 유한한 전기장 차폐 길이(screening length)와 전극의 비강유전성 계면층의 존재로 인해 어떤 반도체와 금속 전극을 사용하더라도 불가피한 것이다.[38,39] 기존 페로브스카이트 구조 강유전체는 유전율이 수백 단위로 매우 높기 때문에 인가 전압이 각 층에 불균형하게 분배된다. 이러한 전압 분배 효과는 강유전체층과 Si 채널 사이에 낮은 유전율을 가지는 계면층을 강제하고 그 결과 탈분극 전기장의 영향이 강화된다. 또한, 기존 페로브스카이트 기반 강유전체들은 약 50-100 kV/cm 정도의 항전계를 가진다. 따라서 일정 값 이상의 안정된 MW를 확보하기 위해서는 거의 100 nm이상의 박막 두께가 필요하다.
반면에 HfO2 기반 강유전체의 경우 기존 강유전체와 비슷한 P r을 가지고 있음에도 불구하고 (15–45 µ C/ cm2), 기존 강유전체보다 훨씬 더 높은 1-2 MV/cm 정도의 높은 항전계를 가지고 있다. 결과적으로 1–10 nm 두께에서 안정적인 강유전 특성으로 인해 게이트 층의 두께를 크게 줄일 수 있다. 또한, 큰 띠틈(band gap) (5.3-5.7 eV) 과 Si과의 띠 어긋남(band offset)으로 인해 10 nm 미만의 매우 얇은 필름에 대해서도 누설 전류를 제어할 수 있다.[40] 따라서 FeFET 소자의 소형화에서 강유전성 HfO2는 기존 강유전성 물질들의 한계를 극복할 수 있는 뚜렷한 장점을 보인다. Dunkel et al. 은 22 nm 수준의 FeFET 양산이 가능함을 보이며 FeFET 를 이용한 비휘발성 메모리 소자가 저비용, 고효율의 차세대 응용 소자로 쓰일 수 있음을 보고했다.[7]
2.2.2 음의 전기용량 전계효과 트랜지스터 (negative capacitance field effect transistor, NCFET)
소자 동작의 에너지 효율성에 대한 연구는 계속해서 발전해 왔다. 기술의 발전이 가속화될수록 우리는 실용적인 한계를 넘어서 물리적, 근본적인 에너지 효율의 한계에 다가서고 있다. 에너지 효율에 대한 연구 초기에는 Fig. 2와 같이 새로운 물질들을 게이트 산화물의 대체제로 응용하여 얇은 두께와 낮은 전압에서 동작할 수 있는 소자들을 개발해 왔다. 볼츠만 전자 분포에 의한 근본적인 에너지 효율의 한계에 도달한 지금 이를 극복하기 위한 새로운 방안이 필요하다. “Boltzmann limit”이라고 부르는 이 한계점은 다음과 같은 수식으로 나타낼 수 있다. 문턱 전압 이하 특성(Subthreshold swing, S 또는 SS) 값은

상용 금속-산화물-반도체 전계 효과 트랜지스터(MOSFET) 기술에서 공급 전압 V dd 및 등가 산화물 두께(EOT) 감소의 연도별 경향. 검은색 점선은 Si 채널과 고유전율 재료 사이에 필요한 SiO2 인터페이스에 의해 주어진 EOT 한계를 나타내고 빨간색 점선은 Boltzmann limits으로 인한 최소 공급 전압을 나타낸다. HKMG: High-k Metal Gate. NC: Negative capacitance. Reprinted from Hoffmann et al., APL Materials 9, 020902 (2021) with the permission of AIP Publishing[42].
여기서 k B는 볼츠만 상수, T는 온도, q는 단위 전하, Ψ s는 표면 전위, C s와 C ins는 각각 반도체층과 게이트 유전체층의 전기용량이다. 일반적으로 C s와 C ins는 양수이기 때문에 C s/C ins 값은 0보다 작을 수 없다. 따라서 S 값은 60 mV/dec 이하로 작아질 수 없다. 이런 근본적인 한계를 돌파하기 위한 방안으로 제시된 것이 음의 전기용량 값을 갖는 축전기를 이용한 음의 전기용량 전계효과 트랜지스터이다. 앞서 말한 수식에서 음의 전기용량를 갖는 물질이 게이트 영역에 들어간다면 C ins의 값에 따라 기존 Boltzmann limits을 넘어 S 값이 60 mV/ dec 이하로 작아질 수 있다 (Fig. 3).
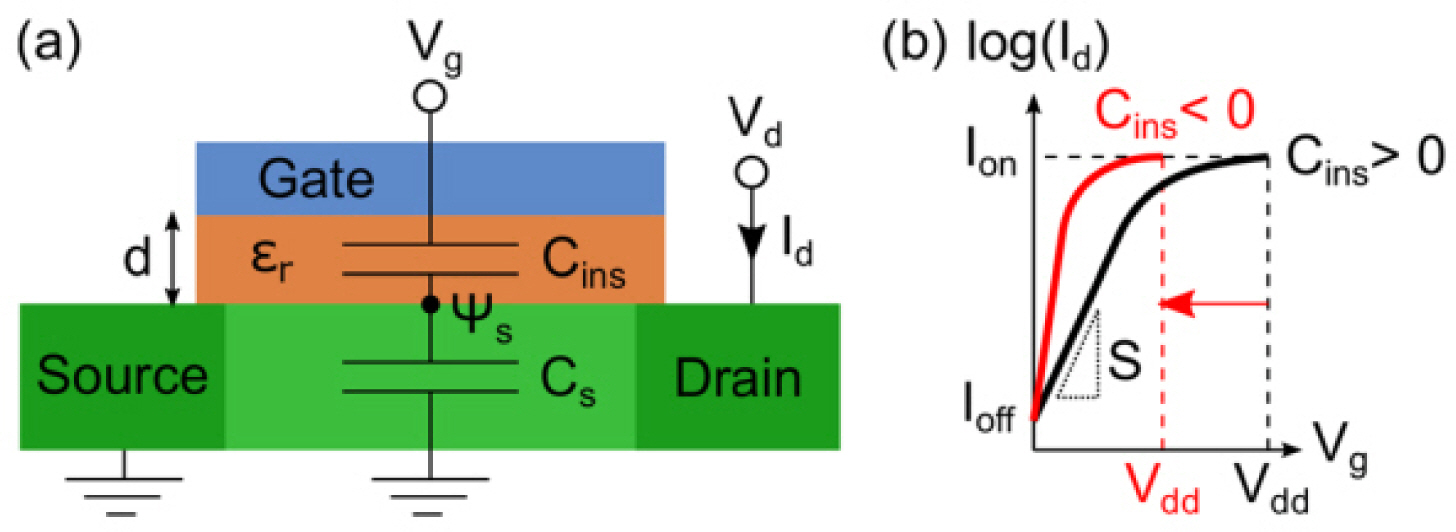
a. MOSFET 구조의 회로도. 여기서 C ins, d 및 ε r은 각각 게이트 절연체의 전기용량, 두께 및 상대 유전율이고, C s는 반도체 용량, Ψ s는 표면 전위, V g 및 V d는 각각 게이트 및 드레인 전압. b. 절연체의 전기용량이 양수 음수인지에 따른 개략적인 MOSFET transfer characteristic 그래프. V dd는 공급 전압이고 I on과 I off는 각각 “켜짐” 및 “꺼짐” 상태의 드레인 전류. S는 문턱전압 이하 기울기. Reprinted from Hoffmann et al., APL Materials 9, 020902 (2021) with the permission of AIP Publishing[42].
음의 전기용량은 란다우 이론(Landau theory)을 따르는 강유전체에서 확인할 수 있다.[43] 란다우 자유에너지는 다음과 같은 수식으로 나타낼 수 있으며,
여기서 P는 분극, E는 전기장, a와 b는 상수로 상수 a 의 값에 따라 상유전체(a>0)와 강유전체(a<0) 특성이 나타난다. 이 때 자유에너지의 최소값으로부터 외부전기장과 분극의 S-형태에서 음의 상관관계를 가지는 영역을 확인할 수 있다. P=0, E=0인 상태를 기준으로 분극 상태의 증가는 내부 전기장을 감소시키면서, 더 낮은 에너지 상태를 만든다.[44] 하지만 일반적인 실험에서는 S-형 보다 이력곡선(hysteresis) 형태로 P-E 그래프가 그려지며 양의 전기용량만 확인할 수 있다. 강유전체/유전체 이종접합 구조에서 음의 전기용량 상태를 안정화할 수 있는데, 이러한 구조에서는 강유전체층의 분극에 대한 차폐를 유전체층이 방해하게 된다. 이 과정에서 생기는 탈분극 전기장이 복원력처럼 작용하면서 음의 전기용량 상태를 안정화한다.[43]
위의 이유로 NCFET혹은 음의 전기용량에 의한 효과를 확인하기 위한 실험은 주로 MFIS와 같은 구조에서 진행된다. NCFET에서 가장 중요한 효과는 S 값이 60 mV/dec이하로 내려갈 수 있는 가이다. 강유전성 HfO2를 이용한 최근 연구들에서는 일정 영역에서 S 값이 60mV/dec 근처 혹은 이하로 나타나는 것을 보고하였다. Li et al.은 8-nm Hf0.5 Zr0.5 O2와 6-nm Al2 O3를 이용하여 게이트를 구성해 S값이 일부영역에서 최소 52.8 mV/dec까지 줄어드는 것을 확인하였다.[45] Fig. 4와 같이 Cho et al.은 펄스 레이저 증착법을 이용하여 증착한 Hf0.5 Zr0.5 O2를 이용하여 최소 20.42 mV/dec의 S 값을 보였으며,[46] Kwon et al.은 1.8 nm 두께의 Hf1-x Zr x O2를 이용하여 음의 전기용량에 의한 효과를 확인하였다.[47]

a. 강유전성 Hf0.5 Zr0.5 O2를 이용한 MoS2를 채널로 사용하는 NCFET 구조 모식도. b. 강유전성 Hf0.5 Zr0.5 O2의 분극 방향에 따른 소자내 쌍극자 분포와 란다우 에너지 곡선에서 상태 위치 모식도. c. 전기장 인가 방향에 따른 드레인과 소스사이 전류 대 게이트와 소스사이 전압(I ds-V gs) 그래프와 d, e. 전류에 따른 문턱 전압 이하 특성 (SS). Reprinted with permission from Cho et al., ACS Appl. Mater. Interfaces 2021, 13, 50, 60250–60260. Copyright 2023 American Chemical Society[46].
최근 Hoffmann et al.은 Al2 O3와 Hf0.5 Zr0.5 O2의 이종접합 구조에서 고유 음의 전기용량(Intrinsic NC)와 비고유 음의 전기용량(extrinsic NC)의 실험적 구별방법에 대해 보고하였다.[10] 이들의 보고에 따르면 Fig. 5과 같이 외부 전압이 없을 때, 차폐되지 못한 분극 P0는 탈분극 전기장을 형성해 같은 크기의 도메인쌍을 형성하게 된다. 이때 외부전압에 의해 분극 상태가 변화하는데 이때 도메인 벽 이동(domain wall motion)에 의해 도메인 영역이 변화할 경우 비고유 음의 전기용량 효과가 나타나고, 도메인 영역의 변화 없이 쌍극자 전환에 의해 분극 상태가 변화할 경우 고유 음의 전기용량이 나타난다. 이때 비고유 음의 전기용량은 분극과 강유전체층의 전기장 사이 관계에서 (P-E f) S-형태의 그래프를 나타내고, 고유 음의 전기용량의 경우 이중 S-형태의 그래프를 나타낸다. 추가적으로 비고유 음의 전기용량의 경우 도메인 벽 이동에 의해 분극의 변화가 진행되기 때문에 두께에 따른 항전계의 변화가 두드러지는 반면 고유 음의 전기용량의 경우 고정된 항전계값을 보인다.[48] 이 방법을 바탕으로 Hf0.5 Zr0.5 O2 박막의 음의 전기용량 특성을 확인하였을 때, Al2 O3/Hf0.5 Zr0.5 O2/Al2 O3 구조에서 이중 S-형태의 P-E f 그래프를 보였고 두께에 따른 항전계를 확인하였을 때에도 고유 음의 전기용량 특성을 확인할 수 있었다. 이외에도 강유전성 HfO2에서 음의 전기용량에 대한 여러 연구가 진행되었고 NCFET 소자에 대한 성능도 보고되었지만, 음의 전기용량을 이용한 소자의 상용화를 위해서는 더 많은 근본적 이해가 필요한 시점이다.[49]
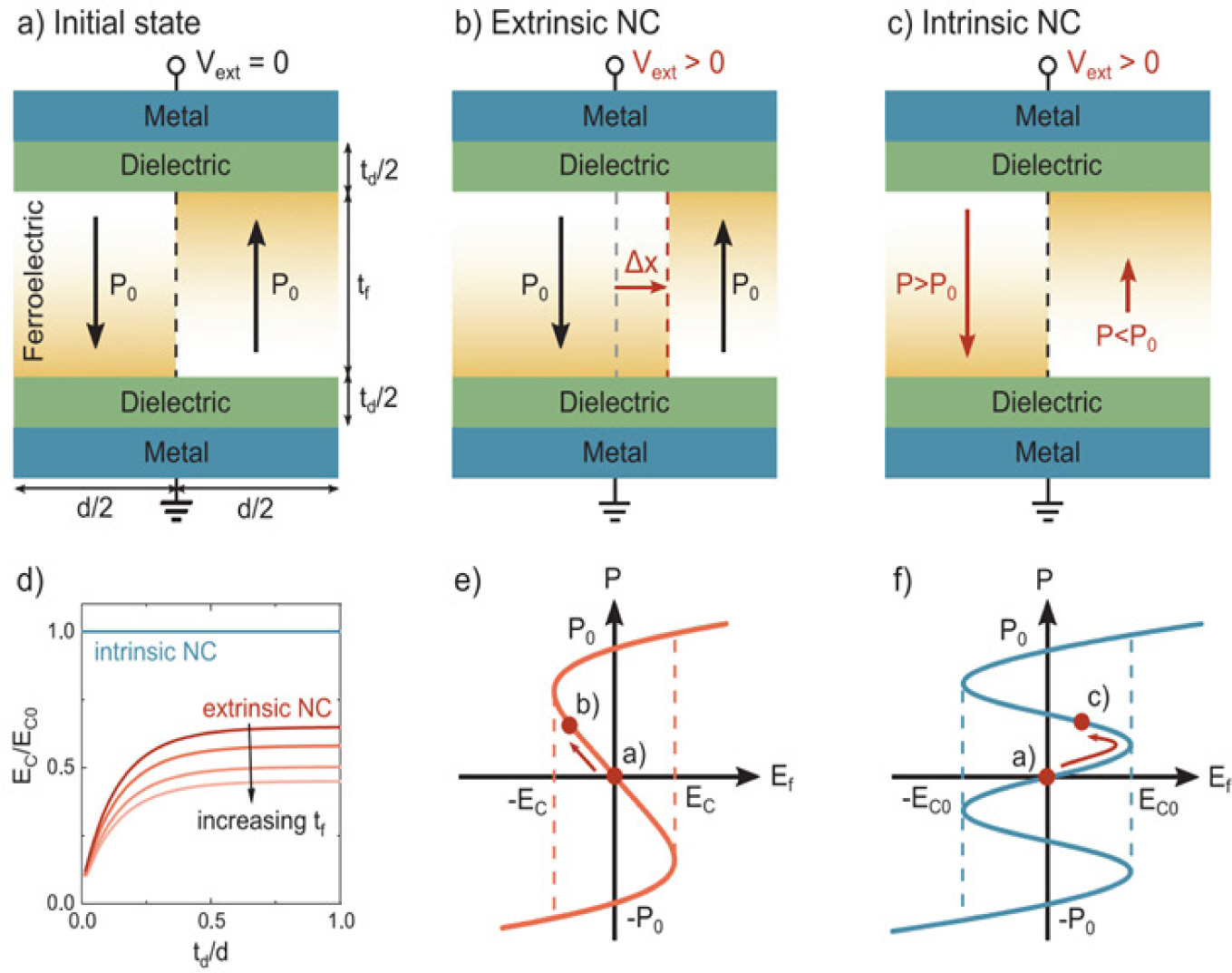
멀티-도메인 강유전체/유전체 이종접합 구조 축전기의 비고유-고유 음의 전기용량특성. V ext: 외부 전압, P0: 자발 분극, t d: 유전체 두께, t f: 강유전체 두께, d: 도메인 주기. A. V ext = 0V에서 초기 강유전성 멀티-도메인 상태. b. 비고유 음의 전기용량로 이어지는 V ext> 0에 대한 수평방향의 도메인 벽 이동의 모식도. c. 고유 음의 전기용량로 나타나는 V ext> 0에 대한 멀티-도메인 구조의 분극 변화 모식도. d. t f 및 t d/d에 대한 고유 항전계 E C0에 대해 정규화 된 항전계 E C의 이론적 계산. e. 비고유 음의 전기용량 및 f. 고유 음의 전기용량에 대한 강유전체의 평균 분극 P 대 평균 전기장 E f. Reproduced from Hoffmann et al., Adv. Funct. Mater. 2022, 32, 2108494., with permission of John Wiley & Sons, Ltd[10].
음의 전기용량을 가지는 강유전성 물질 중 HfO2가 주목받는 이유는 Si 소자 공정에 적합하다는 점도 있지만, 페로브스카이트 구조의 물질들과 다른 강유전성 거동을 보인다는 점이 중요하다. 페로브스카이트 구조의 강유전체에서는 강유전체 분극이 강유전체 도메인의 형성과 도메인 벽 이동으로 이루어진다. 이때의 음의 전기용량 효과는 앞서 말한 강유전체의 고유한 특성과 구별된다. 반면에 강유전성 HfO2에서는 란다우 이론에 부합하는 고유 음의 전기용량 특성을 보였다.[50–52] 이는 최근 보고된 개별 도메인 전환을 가능하게 하는 HfO2만의 독특한 강유전성 거동과도 연관이 있다.[53]
2.3 강유전성 HfO2를 이용한 차세대 소자
2.3.1 뉴로모픽 소자(Neuromorphic device)
뉴로모픽 소자는 인간의 신경망 구조와 그 기능을 모방한 소자로 기존 폰-노이만 구조(von Neumann architecture)의 한계를 뛰어넘을 것으로 기대한다. 이 때 중요한 기술은 정보전달의 핵심 과정이라고 할 수 있는 시냅스의 전기적 거동을 모방하는 것이다. 실제 시냅스에서 정보전달과 처리, 저장을 위해 발생하는 스파이크(spike) 신호에 대한 반응을 소자에서 여러 상태로 저장할 수 있어야 한다.[54] 그렇기 때문에 부분적인 강유전 쌍극자 전환과 안정적인 다중 분극 상태가 뉴로모픽 소자를 구현하는데 필수적이다.
뉴로모픽 소자는 일반적으로 격자 무늬 형태의 시냅스 소자(synaptic device)들의 배열로 구성되어 있고 소자 동작은 가중 합계 연산이 병렬로 처리된다.[9] 먼저 읽기 전압이 배열의 행에 공급된 다음 벡터 형렬 곱셈 (vector-matrix multiplication, VMM)을 통해 시냅스 소자와 상호작용한다. 이후 열을 따라 전류 혹은 전압 값이 합산되어 출력된다.[55] 그리고 시냅스 소자의 가중치(weight) 값이 순전파와 역전파 상호작용(feed-forward and back-propagation interaction) 형태의 심층 신경망(deep neural network, DNN) 모델 훈련 과정을 거쳐 학습된다.
시냅스 소자 구현을 위해서는 점진적인 가중치의 변화가 필요하다. 강유전성 P r로 가중치를 조절하는 소자의 경우 static Preisach model을 고려한다면, 인가한 전압의 조절로 부분적인 강유전 쌍극자 전환을 만들어 정보상태를 세분화하여 변화시킬 수 있다.[56] (Fig. 6) 신뢰도 있는 시냅스 소자를 구현하기 위해서는 안정된 비휘발성 분극 상태와 함께 부분적인 분극 상태가 유지되어야 한다. 그러나 기존의 강유전성 물질들은 다중 분극 상태를 유지하고 제어하는데 어려움이 있었다. 반면 강유전성 HfO2는 안정적인 자발 분극 상태와 외부 전기장을 이용하여 강유전성 분극 도메인을 손쉽게 조절해 다중 분극 상태를 만들어 낼 수 있다. Lee et al.은 강유전성 쌍극자 전환 동역학과 P-E 이력곡선의 온도 의존성과 압전힘현미경 분석등을 통해 HfO2의 다중 분극 상태가 안정함을 보였다.[57] 실험결과 도메인 핵 생성을 위한 임계 부피 크기(critical volume size)가 매우 작고, 강유전성 쌍극자가 부분적으로 전환되었을 때, 큰 활성화 에너지 장벽을 가지고 있음을 보였다 (Fig. 7). 또한 몬테 카를로 시뮬레이션(Monte Carlo simulation)을 통해 임계 부피 크기에 따른 안정성을 재현했다 (Fig. 8).

a. 2 μs 전압 펄스를 사용한 Si 도핑 된 강유전성 HfO2의 분극 상태. b. 100회 반복된 각 분극 상태의 히스토그램. c. 2.1 V, 2 μs 전압 펄스를 사용하는 중간 분극 상태의 Weibull 통계 피팅 신뢰도 결과 (주황색 음영은 95% 신뢰 구간). d. Weibull 지수 값 k 및 표준 편차 대 평균 비율 Δ/μ로 표시한 각 분극 상태의 통계 결과. Reprinted with permission from Lee et al. ACS Applied Materials & Interfaces 2019 11 (42), 38929-38936. Copyright 2023 American Chemical Society[57].

강유전성 핵형성에 대해 서로 다른 임계 부피를 사용한 몬테 카를로 시뮬레이션 결과. a. 고정 길이에서의 임의의 분할 개수로 나누어진 강유전체 핵생성 크기의 모식도. b. 서로 다른 개수로 분할된 모델에서 100회 반복하여 부분적인 도메인을 형성했을 때 분극 상태의 분포 피팅 결과. Reprinted with permission from Lee et al. ACS Applied Materials & Interfaces 2019 11 (42), 38929-38936. Copyright 2023 American Chemical Society[57].
실제 소자에서 강유전성 쌍극자 전환은 인가 전압의 크기에 의해서만 조절되는 것이 아니라 인가 전압의 길이나 횟수에도 영향을 받는다. 항전계를 넘어선 전압이 가해지지 않더라도 충분한 크기의 전압이 장시간, 반복적으로 인가되면 이로 인해 점진적인 분극 변화(accumulative excitation)가 일어나게 된다. 이러한 강유전성 쌍극자 전환 메커니즘에 대한 해석 중 하나는 Merz 법칙이다[58]. Merz는 BaTiO3의 분극 반전 시간(switching time)이 전기장에 대해 지수함수적 경향성을 보여주며 강유전성 쌍극자 전환이 강유전성 도메인의 초기 핵 생성과 이후 도메인 성장으로 이루어진다고 설명했다. HfO2의 경우에는 이후 Kolmogorov-Avrami-Ishibashi에 의해 제시된 Kolmogorov-Avrami-Ishibashi 모델(KAI model) 혹은 핵형성기반 분극 전환(nucleation limited switching 모델(NLS model)로 강유전성 쌍극자 전환 동역학이 분석되고 있다.[59–61] 이러한 연구는 분극 반전 시간과 인가 전압의 크기, P r간의 상관관계를 밝힘으로써 소자의 동작 시간과 동작에 필요한 전압/에너지 등을 예상하고 조정할 수 있다는 점에서 기술 응용에 매우 중요하다.
2.3.2 강유전체 터널링 접합 소자 (Ferroelectric tunnel junction, FTJ)
FTJ 또는 강유전체 다이오드는 HfO2 기반 시냅스 장치에서 비파괴적 읽기 메커니즘과 초저전력 소자 동작으로 인해 많은 관심을 끌었다.[62–64] FTJ 소자는 분극 방향에 따라 달라지는 터널링 장벽의 변화를 통해 소자의 저항을 변화시키는 방식으로 정보를 저장한다. 그리고 이를 위해서는 Fig. 9와 같이 서로 다른 전극을 이용하거나 추가적인 유전체층을 이용하여 비대칭적 소자 구조를 구현해야 한다. FTJ소자의 단점은 터널링 전류를 이용하기 때문에 소자동작을 하기 위한 충분한 전류밀도를 확보하기 어렵다는 것이다. 이를 개선하기 위해선 1 nm 크기의 매우 얇은 강유전층을 이용하여 소자 동작 시 전류 밀도를 높여야 한다.
HfO2가 1 nm 두께에서도 강유전성을 유지할 수 있다는 점은 FTJ소자 개선에 매우 유용하다.[65] Lee et al. 은 1 nm 두께의 단결정 Y:HfO2 박막을 Si 기판위에 증착하여 FTJ 소자를 구현하였다.[66] 분극 방향에 따라 106의 On/Off 전류 비율을 확인하였고, 강유전성 분극 방향에 따른 전기장이 터널링 에너지 장벽의 형태를 변화시키면서 이와 같은 큰 On/Off 전류 비율을 확보할 수 있다고 보고하였다. 이들은 HfO2의 복소 밴드 구조(complex band structure)를 계산하여 기존 FLASH 소자와 견줄만한 On/OFF 터널링 전기저항(tunnel electroresistance, TER)값이 실험적, 이론적으로 가능함을 보였다. (Fig. 10)

복소 밴드 구조를 사용한 강유전성 분극 방향에 따른 전류 값 피팅. a. 다수의 작은 직사각형으로 분할한 임의의 에너지 장벽 분포. b. HfO2의 복소 밴드 구조. c. 분극 방향에 따른 각각 On(주황색) 및 Off(녹색)의 터널링 에너지 장벽 모식도. d. TiN/Y:HfO2/SiO x/ Si(001) 구조의 소자가 On(주황색) 및 Off(녹색) 상태일 때 계산된 전류-전압 그래프. Reprinted from, Applied Materials Today 26, Lee et al., Giant tunneling electroresistance in epitaxial ferroelectric ultrathin films directly integrated on Si, 101308, Copyright2023, with permission from Elsevier[66].
2.3.3 강유전성 축전기 소자(Ferroelectric capacitor, FeCAP)
앞서 소개된 FeFET나 FTJ와 같은 소자는 모두 저항 기반의 시냅스 소자이다. 하지만 최근 강유전성 HfO2의 전기용량 변화를 기반으로 하는 FeCAP 구조의 시냅스 소자가 개발되고 있다.[68,69] FeCAP 소자는 FTJ와 유사하게 비대칭적 소자 구조를 만들고 이로 인해 생기는 작은 교류 전압 신호(small AC signal)에 대한 전기용량의 변화로 정보 상태를 저장한다 (Fig. 11). 읽기 동작 시 트랜지스터의 채널과 같은 전류 통로를 만들지 않기 때문에 저전력 소자 구동이 가능하다. 그리고 기존의 1T-1C 구조의 FeRAM과 비교했을 때 축전기의 강유전체 분극으로 정보 상태를 저장한다는 점은 유사하지만 전혀 다른 읽기 방법을 가지고 있다는 점에 유의해야한다. FeCAP의 경우 FTJ와 같이 비파괴적 작은 교류 전압 신호를 이용하여 시냅스 소자의 기능을 한다.

a. 원자층 증착 방식을 이용하여 증착한 MFM구조의 Hf0.5 Zr0.5 O2 축전기에서 직류 전압 인가에 따른 작은 교류 전압 신호에 대한 반응과 분극 상태 변화. b. 교류 전압 신호의 주파수 변화에 따른 전기용량 특성 변화 c. 85°C 환경에서 분극 상태 별 보존성. d. 교류 전압 신호의 전기장에 따른 유전율 변화. Reprinted from Yuan et al., Appl. Phys. Lett. 117, 073501 (2020), with the permission of AIP Publishing[69].
Luo et al. 은 도메인 고정 효과에 의한 비대칭적 강유전성 분극 상태를 통해 FeCAP 소자를 구현했다. 이들의 연구에서 (metal1-ferroelectric-metal2)M1 FM2구조의 FeCAP소자는 HfO2와 전극 사이의 계면층이 상부 전극과 하부 전극에 따라 다르게 구성되어 산소 공공 분포의 불균형을 만들었고, 이로 인해 한쪽 방향의 도메인 고정 효과가 나타난 것으로 추측한다. 이들이 구현한 FeCAP 소자는 약 104 회의 내구성과 10년 이상의 보존성을 보이며 차세대 소자로서 응용 가능성을 보였다.[69]
2.3.4 단위 격자 크기의 소자(Unit-cell size devices)
HfO2의 실험적 다중 분극 안정성에 대한 보고에 이어 최근에는 단위 격자 크기의 소자구현 가능성에 대한 이론적 연구가 보고되었다.[53] (Fig. 12). Lee et al.의 보고에 따르면 강유전성 HfO2의 구조는 강유전성 HfO2의 고유한 특성이라고 할 수 있는 평평한 포논 밴드(flat phonon band)를 형성한다. 평평한 포논 밴드의 형성은 굉장히 얇은 도메인 벽을 가능하게 하고 따라서 단위 격자의 절반 크기 도메인을 가능하게 한다. 극성 Γ z 반극성 Yz 5 포논이 동일한 크기로 동위상으로 합쳐져 분15 및 극을 갖는 극성 강유전체층과 무극성-스페이서층의 반복으로 구성된 사방정계상 구조를 생성한다. 이러한 강유전체층과 무극성-스페이서층의 반복적인 구조가 본질적으로 국소화(localized) 된 HfO2의 강유전 쌍극자를 만든다.
HfO2 내의 독립적인 강유전 쌍극자들은 도메인 벽, 표면 노출(surface exposure)과 같은 외적요인들에 안정적이다. 또한 sub-nm 크기의 국소화 된 강유전 쌍극자는 도메인 벽 에너지에 큰 변화를 발생시키지 않고 개별적으로 전환할 수 있다. (Fig. 13). PbTiO3의 연속된 단위 격자에서 개별 분극의 스위칭이 불안정하고 단일 방향의 분극 상태에서만 안정된 거동을 나타내는 반면, HfO2는 모든 개수의 개별 도메인 전환 상태에서 동일한 에너지 준위로 안정적이기 때문에 다중 분극 상태가 가능하고 도메인 크기에 제한받지 않는 강유전성을 보인다. 기존 페로브스카이트 구조의 강유전체에서 E c는 E a 보다 10배 작지만 Ea의 값은 HfxZr1-xO2와 크게 다르지 않다. 이는 집합적 및 개별 도메인 전환이 동일한 전기장에서 발생함을 의미한다. 개별 도메인 전환이 가능한 이유는 제1원리 계산으로 확인된 바와 같이 HfO2는 무극성-스페이서층의 반복적인 형태로 구성되어있고 이로 인해 도메인 너비에 임계 길이가 존재하지 때문이다. 이러한 결과는 이론적으로 단위 격자 크기의 소자 구현이 가능하다는 것을 시사한다

HfO2의 스위칭 거동을 드러내는 실험적 활성화 전기장 E a및 항전계 E c의 관계와 0.27 nm 폭의 도메인 전환을 보여주는 에너지 시뮬레이션. a. 다양한 강유전체 물질의 E a와 E c 간의 관계. b. HfO2(상단) 및 PbTiO3(하단)에서 균일한 분극 상태와 국소적인 분극 전환 상태의 경로를 따라 계산된 에너지. c. 격자 위치 별 분극 전환 에너지 분포. d. 초고밀도를 갖는 HfO2 기반 메모리 소자의 모식도. From Lee et al., Science 369 (6509), 1343 (2020). Reprinted with permission from AAAS[53].
3. 결론
본 글에서는 차세대 소자들의 구조와 동작 원리에 기반하여 강유전성 HfO2의 특성들이 소자들의 성능을 어떻게 개선할 수 있는지 알아보았다. 강유전성 HfO2의 Si 공정호환성, 1-2 nm 두께의 박막에서의 안정된 강유전성, 단위 격자 수준까지 세분화가능한 부분적인 분극 전환 등이 소자응용에 강점으로 나타났다. 이러한 강점들은 강유전성 HfO2 기반 소자의 상용화를 가속화하지만 물리적 특성에 대한 이해 없이는 기술 개발의 한계에 봉착할 수밖에 없다. 현재, NCFET 분야는 음의 전기용량에 대해 더 깊은 이해를 필요로하고, FeCAP과 같이 새로운 형태의 소자는 상용화까지 더 많은 연구를 필요로 할 것으로 예상한다. 본 글을 통해 응용 기술과 물리적 특성 사이의 관계를 이해하고, 현 소자 기술과 강유전성 HfO2에 대한 이해도의 간극을 파악해 메워 나갈 수 있는 기회가 되길 기대한다.
References
Biography

◉◉송 명 섭
◉ 2018년 서울대학교 물리교육 학사
◉ 2020년 서울대학교 물리교육 석사
◉ 2020년-현재 서울대학교 물리교육 박사 과정

◉◉채 승 철
◉ 2003년 서울대학교 물리교육 학사
◉ 2005년 서울대학교 물리학 석사
◉ 2009년 서울대학교 물리학 박사
◉ 2009년-2013년 Rutgers University 박사 후 연구원
◉ 2013년 LG Display 선임 연구원
◉ 2014년 가천대학교 조교수
◉ 2015년-2018년 서울대학교 조교수
◉ 2018년-현재 서울대학교 부교수


